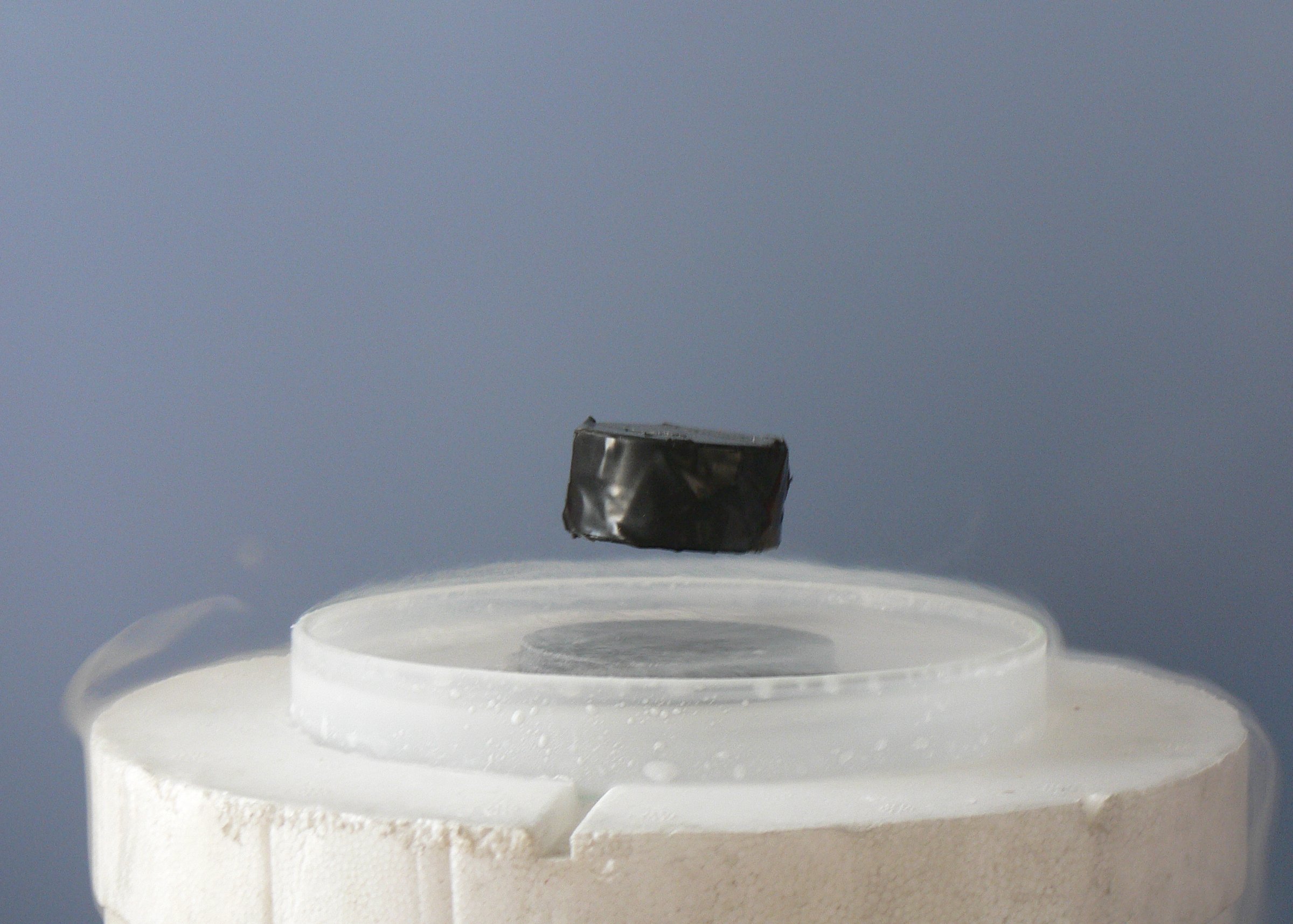
Photo from academic.microsoft.com
Abstract Dislocations in shock loaded tantalum single crystals were imaged using both transmission electron microscope (TEM) and electron channelling contrast image (ECCI) in a scanning electron microscope with a conventional… Click to show full abstract
Abstract Dislocations in shock loaded tantalum single crystals were imaged using both transmission electron microscope (TEM) and electron channelling contrast image (ECCI) in a scanning electron microscope with a conventional backscattered electron detector. The results were compared with backscattered electron intensity profiles across dislocations calculated via the dynamic theory of electron diffraction. A one-to-one correspondence between ECCI and TEM is established. High voltage and low index reflections should be used to obtain the highest dislocation contrast and greatest imaging depth.
Journal Title: Philosophical Magazine
Year Published: 2017
Link to full text (if available)
Share on Social Media: Sign Up to like & get
recommendations!