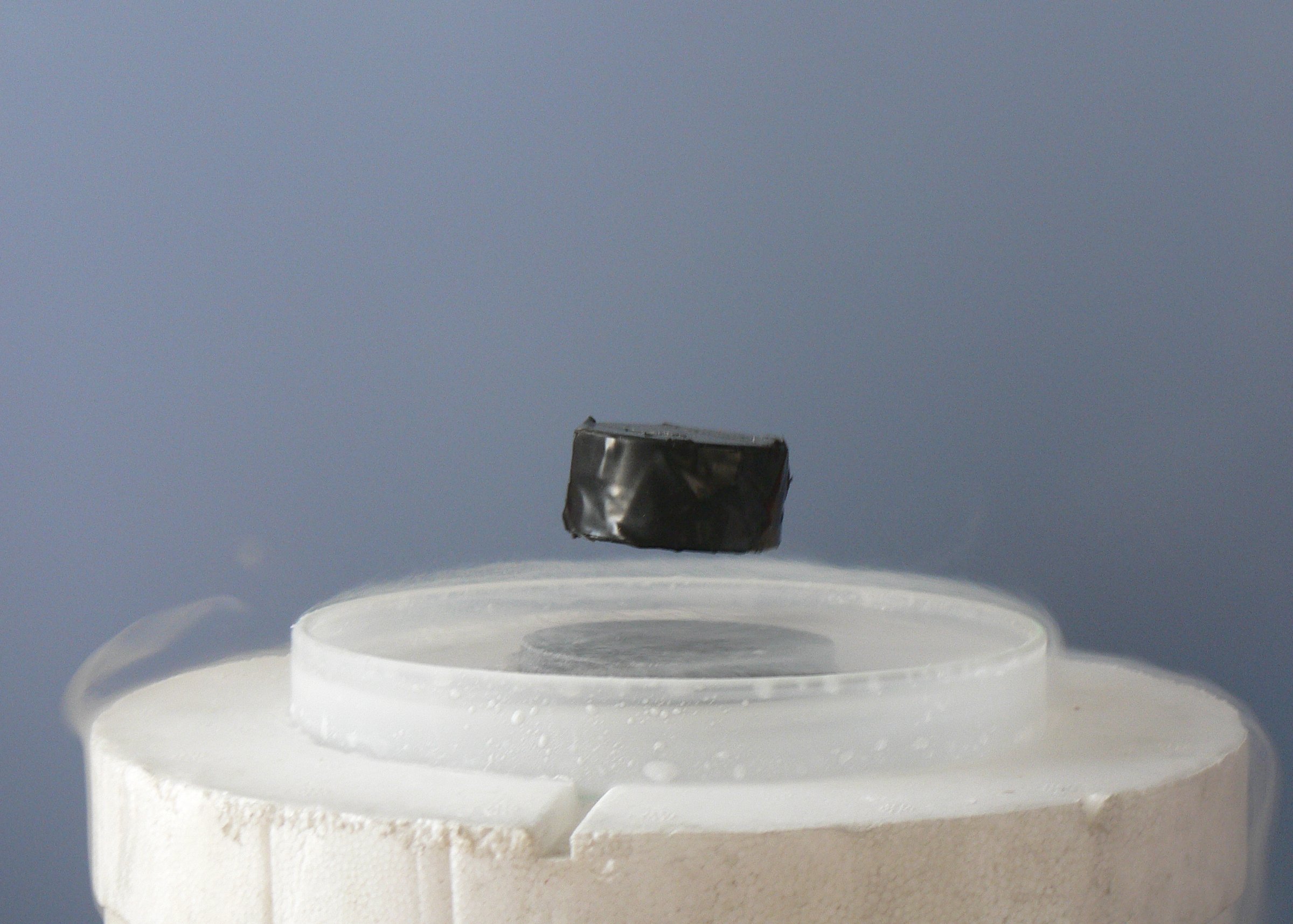
Photo from academic.microsoft.com
The heterogeneous integration of III–V devices with Si-CMOS on a common Si platform has shown great promise in the new generations of electrical and optical systems for novel applications, such… Click to show full abstract
The heterogeneous integration of III–V devices with Si-CMOS on a common Si platform has shown great promise in the new generations of electrical and optical systems for novel applications, such as HEMT or LED with integrated control circuitry. For heterogeneous integration, direct wafer bonding (DWB) techniques can overcome the materials and thermal mismatch issues by directly bonding dissimilar materials systems and device structures together. In addition, DWB can perform at wafer-level, which eases the requirements for integration alignment and increases the scalability for volume production. In this paper, a brief review of the different bonding technologies is discussed. After that, three main DWB techniques of single-, double- and multi-bonding are presented with the demonstrations of various heterogeneous integration applications. Meanwhile, the integration challenges, such as micro-defects, surface roughness and bonding yield are discussed in detail.
Journal Title: Journal of Semiconductors
Year Published: 2021
Link to full text (if available)
Share on Social Media: Sign Up to like & get
recommendations!